芯片的封装怎么去除
时间:2025-08-16 11:11 阅读数:8228人阅读
*** 次数:1999998 已用完,请联系开发者***
≥▽≤ 成都奕成集成电路申请芯片封装方法及结构专利,减少芯片层制作导电...本申请提供一种芯片封装方法及芯片封装结构,涉及半导体制造技术领域。在上述的芯片封装方法中,通过在制作好关于对称面A‑A对称的第一芯片层以后,去除第一载板并在第芯片层相对的两侧同时制作通过连接通孔连接导电层从而减少第一芯片层在制作导电层由于两侧热膨胀系数不...
+^+ 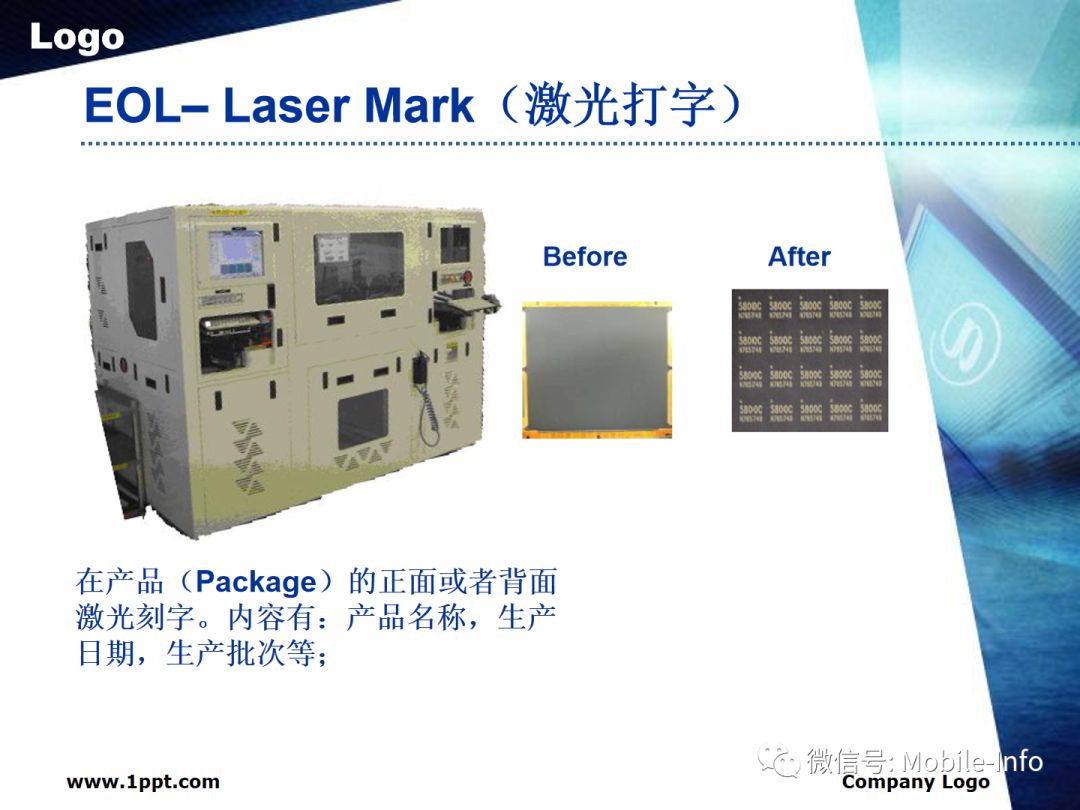
≡(▔﹏▔)≡ 长电科技申请封装结构及其形成方法专利,研磨去除工艺残留物少损伤小一种封装结构及其形成方法,形成方法,在形成包覆感光芯片和覆盖基板的第一表面的塑封层,且塑封层暴露出感光芯片的上表面和并暴露出侧面... 感光芯片的上表面以及部分第一金属屏蔽层的表面形成第二金属屏蔽层;研磨去除感光芯片的上表面上的第二金属屏蔽层,暴露出感光芯片的上...

武汉市三选科技取得消除渗胶的底部填充胶相关专利金融界2024年11月12日消息,国家知识产权局信息显示,武汉市三选科技有限公司取得一项名为“消除渗胶的底部填充胶、其制备方法和2.5D芯片封装结构”的专利,授权公告号CN 118620563 B,申请日期为2024年8月。

飞飞加速器部分文章、数据、图片来自互联网,一切版权均归源网站或源作者所有。
如果侵犯了你的权益请来信告知删除。邮箱:xxxxxxx@qq.com





